53xx BDA Universal Fine Wire & Die Bonder Specifications
|
Concept |
DC motor driven
linear Z axis
Single board PC
with Windows®
operating system
Menu controlled
teach
User interface
via colour screen and shuttle-wheel with push-button
|
 Bondtec 53xx BDA Datasheet
Bondtec 53xx BDA Datasheet
53xx Video
|
|
Wire types |
Ball-bonding: Gold wire, 17.5 - 50 μM on 2”
spool (˝” Spool optional)
Wedge bonding: Aluminium or Gold wire, 17.5 - 75
μM. Ribbon, 30 x 12.5µM - 250 x 25 μM
|
|
Bondhead |
Ball bonding or Wedge bonding for fine wire
Capillaries: 9 - 16mm length
Wedges: 0.750" or 1” length
Bond force: programmable, 5 - 150g Voice-coil
bond force system
Contactless electronic touchdown sensor
Programmable
Ultrasonic system: 60 kHz or 100 kHz, switchable
|
|
Display |
6.5” TFT Colour
Display. 640 x 480 Pixel (VGA)
|
|
Working area |
Bondhead linear Z
travel: 60 mm. Step precision: 1µM
Programmable
linear Y axis: 8mm. Step precision 2µM
X&Y Manipulator;
18 x 18 mm Movement ration; 7:1
|
|
Workholder |
Digitally
controlled heated stage
Standard Ř - 80
mm for samples to 2" x 2", mechanical clamping
4" x 4" &
95 mm optional, also with vacuum
|
|
Control modes |
Manual,
semi-automatic
Program line step
for testing via Shuttle-wheel
|
|
Loop types |
Standard
rectangular, Reverse, Stitch, Programmable
|
|
Dimensions |
Height: 400mm,
Width: 630mm, Depth: 580mm. Weight approx. 40kg
|
|
|
|
|
Programme Storage |
Internal Hard
Disc Drive
|
|
|
|
The 53xx BDA is now capable of
DIE-Bonding
Our popular manual
wire bonder 53xx BDA was already a marvel of
versatility, being extremely simple to convert
between wedge and ball bonding. Now it adds a
third functionality; the 53xx BDA is now capable
of DIE bonding.
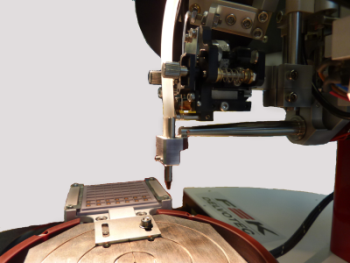 Only
a minimum of changes in hardware and software
are required. In place of the wire bond tool an
adapter is attached directly to the transducer
in order to mount standard tools for chip
bonding, so-called DIE collets. These are
available from a variety of suppliers in
different shank diameters, all of which fit into
the three mounting holes. The chips are supplied
in waffle packs which can be mounted right next
to the standard bonding chuck. Only
a minimum of changes in hardware and software
are required. In place of the wire bond tool an
adapter is attached directly to the transducer
in order to mount standard tools for chip
bonding, so-called DIE collets. These are
available from a variety of suppliers in
different shank diameters, all of which fit into
the three mounting holes. The chips are supplied
in waffle packs which can be mounted right next
to the standard bonding chuck.
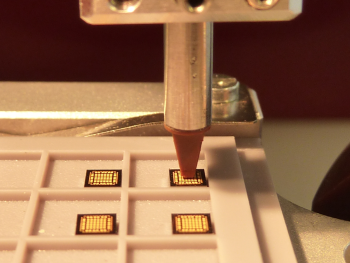 A
special software version makes DIE-bonding on
the 53xx BDA just as straightforward and
comfortable as wire bonding. Step one is to
shift the bonding chuck sideways so that the
waffle pack with the desired DIE comes to sit
just under the DIE collet. Just like for wire
bonding, the user does a fine adjustment under
the microscope with the manipulator. Step two is
to lower the bond tool onto the chip where a
touchdown signal is registered and the vacuum is
switched on automatically which sucks the chip
to the DIE collet. Using this touchdown
procedure makes sure that the chip is touched
with a defined force – a particularly important
feature for sensitive or thin DIE. A
special software version makes DIE-bonding on
the 53xx BDA just as straightforward and
comfortable as wire bonding. Step one is to
shift the bonding chuck sideways so that the
waffle pack with the desired DIE comes to sit
just under the DIE collet. Just like for wire
bonding, the user does a fine adjustment under
the microscope with the manipulator. Step two is
to lower the bond tool onto the chip where a
touchdown signal is registered and the vacuum is
switched on automatically which sucks the chip
to the DIE collet. Using this touchdown
procedure makes sure that the chip is touched
with a defined force – a particularly important
feature for sensitive or thin DIE.
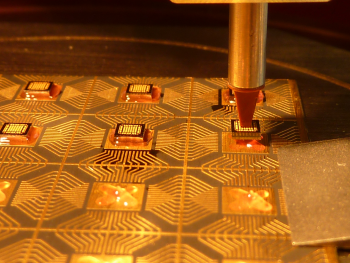 Step
three takes place after the bond tool with the
chip has moved up: the circuit is shifted back
under the bond tool and adjusted precisely,
still using the microscope. The final step
consists of automatic, motorized lowering of the
chip, again under touchdown control, and pushing
the chip into the prepared adhesive bed under a
defined and programmable bond force and bond
time. At this crucial process step, the 53xx BDA
is actually superior to many fully automatic DIE
bonders because it can apply a defined bond
force and time and therefore make sure that even
fragile chips are bonded delicately but over the
full area. This works even when the heights of
the components vary, thanks to the touchdown
feature. Step
three takes place after the bond tool with the
chip has moved up: the circuit is shifted back
under the bond tool and adjusted precisely,
still using the microscope. The final step
consists of automatic, motorized lowering of the
chip, again under touchdown control, and pushing
the chip into the prepared adhesive bed under a
defined and programmable bond force and bond
time. At this crucial process step, the 53xx BDA
is actually superior to many fully automatic DIE
bonders because it can apply a defined bond
force and time and therefore make sure that even
fragile chips are bonded delicately but over the
full area. This works even when the heights of
the components vary, thanks to the touchdown
feature.
Once the chip is attached, the vacuum is turned
off automatically and the bond tool moves to the
programmed height under motor control. The
operator can immediately inspect the chip
placement and the glue fillet.
A particularly attractive aspect of the 53xx BDA
is that the bonder can be switched back to wire
bonding within minutes. By the time the circuit
with the mounted DIE comes out of the curing
oven, the bonder is all ready to go for the
subsequent wire bonding step.
Another special goody: the DIE bond attachment
fits all newer 53xx BDA wire bonders. This makes
it a most welcome add-on for sample building or
small-volume production, all the more so as DIE
bonding is not only cost-effective but even
extremely delicate and, for a manual bonder,
done at high precision. A video is available on
our internet site. |
|
|
 53xx BDA Manual Universal Fine Wire
& Die Bonder
53xx BDA Manual Universal Fine Wire
& Die Bonder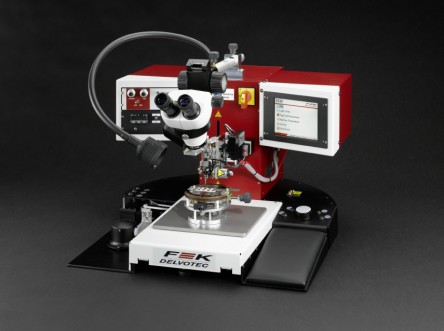
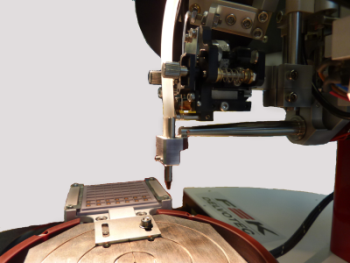 Only
a minimum of changes in hardware and software
are required. In place of the wire bond tool an
adapter is attached directly to the transducer
in order to mount standard tools for chip
bonding, so-called DIE collets. These are
available from a variety of suppliers in
different shank diameters, all of which fit into
the three mounting holes. The chips are supplied
in waffle packs which can be mounted right next
to the standard bonding chuck.
Only
a minimum of changes in hardware and software
are required. In place of the wire bond tool an
adapter is attached directly to the transducer
in order to mount standard tools for chip
bonding, so-called DIE collets. These are
available from a variety of suppliers in
different shank diameters, all of which fit into
the three mounting holes. The chips are supplied
in waffle packs which can be mounted right next
to the standard bonding chuck.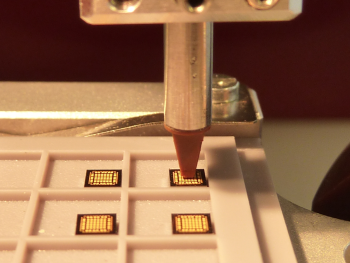 A
special software version makes DIE-bonding on
the 53xx BDA just as straightforward and
comfortable as wire bonding. Step one is to
shift the bonding chuck sideways so that the
waffle pack with the desired DIE comes to sit
just under the DIE collet. Just like for wire
bonding, the user does a fine adjustment under
the microscope with the manipulator. Step two is
to lower the bond tool onto the chip where a
touchdown signal is registered and the vacuum is
switched on automatically which sucks the chip
to the DIE collet. Using this touchdown
procedure makes sure that the chip is touched
with a defined force – a particularly important
feature for sensitive or thin DIE.
A
special software version makes DIE-bonding on
the 53xx BDA just as straightforward and
comfortable as wire bonding. Step one is to
shift the bonding chuck sideways so that the
waffle pack with the desired DIE comes to sit
just under the DIE collet. Just like for wire
bonding, the user does a fine adjustment under
the microscope with the manipulator. Step two is
to lower the bond tool onto the chip where a
touchdown signal is registered and the vacuum is
switched on automatically which sucks the chip
to the DIE collet. Using this touchdown
procedure makes sure that the chip is touched
with a defined force – a particularly important
feature for sensitive or thin DIE.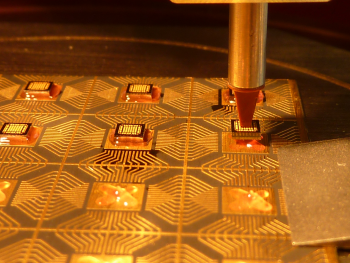 Step
three takes place after the bond tool with the
chip has moved up: the circuit is shifted back
under the bond tool and adjusted precisely,
still using the microscope. The final step
consists of automatic, motorized lowering of the
chip, again under touchdown control, and pushing
the chip into the prepared adhesive bed under a
defined and programmable bond force and bond
time. At this crucial process step, the 53xx BDA
is actually superior to many fully automatic DIE
bonders because it can apply a defined bond
force and time and therefore make sure that even
fragile chips are bonded delicately but over the
full area. This works even when the heights of
the components vary, thanks to the touchdown
feature.
Step
three takes place after the bond tool with the
chip has moved up: the circuit is shifted back
under the bond tool and adjusted precisely,
still using the microscope. The final step
consists of automatic, motorized lowering of the
chip, again under touchdown control, and pushing
the chip into the prepared adhesive bed under a
defined and programmable bond force and bond
time. At this crucial process step, the 53xx BDA
is actually superior to many fully automatic DIE
bonders because it can apply a defined bond
force and time and therefore make sure that even
fragile chips are bonded delicately but over the
full area. This works even when the heights of
the components vary, thanks to the touchdown
feature.